|
�����ܹ�˾��װ�������������������ͼ��ô�,��12�Ҵ�����װ���պ��豸�Ĺ�˾���п�����ʡ��ֽ�������װ������չ��̬��������:
����һ����оƬ���(MCM)��չѸ��
����MCM��90����������һ�����ܶ���װ����,�漰����ߡ��¼�������,���㲼�������켼����оƬ��ߵ�������������칤�����Ƽ�����оƬ���ϻ��Ͳ��Լ�����MCM��װ�����ȡ�MCM ������չ����,���������������й����������ɵ�·�ͻ�ϼ��ɵ�·���쳧��,�������ר�Ź�˾����MCM��ơ����������,���ҷ�չ�ٶ��൱���ˡ�����������װϵͳ��˾MMS(Micro Module Systems Inc.)������1992��,�Ǵ�Digital�豸��˾����������,��Ҫ������װϵͳ��ơ�����, ����������MCM-D��MCM-L������������,ר�ö�оƬ�������оƬ�Ͷ�оƬ��װ,��оƬ��оƬ�������ϻ����ù�˾��Ա��300��,1996��������۶�34����Ԫ,ͬ��10�¸ù�˾�ڹ�ȱ�San Jose�̱���Ϊ5���������Ĺ�˾֮һ���ù�˾�ı�Ĥ�����������쳧�����7300m2,�����ȼ�Ϊ100��,ÿ�ܿ�����5000Ƭ6Ӣ��(150mm)��Ĥ�������塣MMS��˾���û��������ĵ¿���˹������˾��Ħ��������˾��Ӣ�ض���˾�Ͷ������ӵȡ���Ʒ����ˮƽͨ��ISO9001��֤��
����MMS��˾�����MCM-D���и��ܶȵ͵�С��͵�RC�ӳٵ��������źŴ������ԡ��������մɻ��Ƭ�ϵ�����㱡Ĥ,2.54cm�����Ͽ��γɴ��ڻ����1000������,���迹С��50�����߿�һ��10�� m~20��m,���50��m~75��m,��Cu������,�ñ�����(BCB)������ǰ������ʲ�,���1.5��m��12��m�� Cu����������,��������dz���,������BCB������ǰ���������,��˾������õ��ź�������
����MMS��˾��PCB(ӡ�Ƶ�·��)����Ҳ�ж���֮��,�ڲ�����ά(FR��4)��BT��֬�ϲ�ͭ��,�߿� 100��m,���90��m,ͨ��ֱ��200��m�������ĵ���ֵΪ4��10��(�����),����Ƶ��66MHz��100MHz��
����MMS��˾���ñ�Ĥ����������,�о��Ϳ�����һ����С�ķ�װ��ʽ,��оƬ��ģ��װ(CSP),������װ���������оƬ�����20%,�����Ǽ��Ϊ0.5mm����դ���С���ͳ��PWB(ӡ����·��)���̼��Ϊ300mm,�ĵ������2�㲼��,��MMS��˾����������17�㲼�ߡ��ĵײ�����������,������ͭ,�߿���25��m��
�����ù�˾��¿���˹��˾���Ͽ�����Die Mateװ����������оƬ�����ϻ��Ͳ���,Ϊ��Ұ뵼�����칫˾��CPU�ʹ洢��������װ�ͷ�װ,���к�ǿ�ļ���ʵ����
��������оƬ���ϻ��Ͳ��Լ�������֤��оƬ(KGD)�����õ�ʵ��
�뵼�����������쳧�����û��������ǽ�оƬ��װ�Ժ��ٽ����ϻ�ɸѡ�ߵ��²���,������Ϊ��оƬ����½����ϻ��Ͳ��Դ��ںܴ����ѡ���Ϊ��оƬ�缫����С,ֻ����̽��Ӵ�,�ٽ��ϵ����������������,���������߲��Գ�����������,���ܵõ���ȷ�IJ��Խ��������,�ڴ����н����ϻ���ߵ��²��Ի�����Ӵ��������������˪������,���,оƬ�����ϻ��Ͳ���,����������Ϊ���Ŵ�����װ��ƺ�������Ա�����⡣
��������90���,��оƬ����ij��ּ�Ѹ�ͷ�չ,��������Ĺ��ܸ��ӵĴ��ģ�������ģICоƬҪ��װ��һ��������,���Ԥ�Ȳ������ϻ�ɸѡ,��װ���ٽ����ϻ�ɸѡ��ȻҪ��̭���ֲ��ϸ�Ʒ, ����оƬʧЧ��ʹ������Ʒ����,�����ɻ�����ߵ�·�ɱ�������оƬ���ϻ��Ͳ�������Ľ���ͱ�ÿ̲��ݻ�,KGD(Known Good Die)������Ӧ�˶�����
���������������˾�����ⷽ����о�,���������Զ���оƬ������ʱ��װ�����塣����оƬ�����ܶ�оƬ��������,Ҳ��������оƬ�缫,���Է���ʹ�á�оƬ������װ��Ĥ��㲼����, ������ϸ���ĺ���,�������γ���,��оƬ��ߵ�ڶ�㲼������,оƬ�Ϻ�������Ӵ�, оƬ�Ϸ��ĸǰ���е���װ��,ʹ�ǰ���е���,����ʱ��оƬ�����ѹ��,�Ӷ�ʵ�����õĵ�Ӵ���оƬ������װ���о�ϸ���IJ�����,������װ�����Լܻ��ϻ����ϡ������Ϳ��Խ����ϻ���ȫ�¶ȷ�Χ�ĵ����ܲ���,�ϸ�оƬ�ͳ�ΪKGD,��������ȡ��������װMCM�ȵ�·������װ�ó������ᵽ����Die Mate��֮��,����AEHR��˾��������Die Pak������ϵ�в�Ʒ������1�ͱ�2��Die Pak�Ľṹ�����ܼ���3��
  
�����㵹ߵ�������칤�ռ���������ʵ�û�
�����㵹ߵ��������MCM�ؼ�����֮һ,������ȵؼ�С������ͨ·�ϵĸ��ּ�������,����źŴ����������ٶ�,��˷�չҲ�dz�Ѹ��,ͨ����ʹоƬ�缫���㲼���ϵĺ���ֱ�ӻ���,�Ӷ�ʹ���������,оƬ��װռ�ݵĿռ������װ����ʽ��С,����漰�������������:һ�������칤��,�����㵹ߵ������������Ŀǰ�в��ٳ��Ҵ�����Щ������о�������������,���г���Ĺ��պ��豸�����г���
������������TECHNIC��˾��һ��ר�Ŵ��µ�Ʋ����о�������Ĺ�˾,������1945��,����뵼������Ҳ��20�������ʷ���ù�˾��һ�ҿ����˾,����ŷ���ձ��������������Ƕ����зֹ�˾,�����۶�ﵽ1.8����Ԫ������Ҫ��Ʒ����PCB�塢���������뵼�幤ҵ�õ�ƻ�ѧ�Լ�������豸, �漰�Ĺ��ռ����н�����ơ���ѧ�ơ����㡢���������졢��Ƭ�϶�Au����Ni����Cu�ȡ�
����TECHNIC��˾�����û���ͬ��Ҫ�ṩ���ֶ�Һ,��TG25E��ACR434��������Au��,FBCu������ Cu,93NF Sn/Pb�������캸���㡣��˾��ƵĶ�Au�豸��ACR434��Au���25��m,����ʱ��25 min;��100��m����������ʱ��15min��
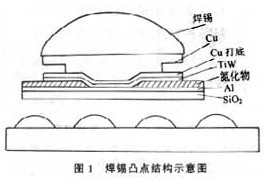
������˾���ṩ51mm��Ƭ����100mm����150mm����200mm��Ƭ�ĵ���豸,��QFP(�ı�������ƽ��װ)��PQFD(�ܷ��ı�������ƽ��װ)��PGA(��դ����)��BGA(��դ����)�͵�ߵ��оƬ�Ȳ�Ʒ�����쳧����Э��,�ṩ������Ҫ��ĵ�ơ����Ʋ������豸�������㼰��ߵ��оƬ��ṹʾ��ͼ��ͼ1��ͼ2��ʾ��
������оƬ��������γ���֮��,��Ҫͨ���㵹ߵ��������оƬ���Ƭ���л���,ʵ�����ֻ������豸���ǵ�ߵ��оƬ���ϻ��������豸�������˾����,������KS��˾���뵼���豸��˾�ȡ��ü��ϻ��Ĺ���ԭ�������Ƚ���ߵ��оƬ���Ƭ���о�ȷ��ͼ1������ṹʾ��ͼͼ2��ߵ��оƬ��ṹʾ��ͼ��ճ���ڻ�Ƭ��,Ȼ�������������ͨ����ѹ(����)����ʹ�䰲ȫճ����һ���豸��Ҫ�����в������:��������ƵĿɼ��ȵ�350���Ĺ���̨,оƬʰ��װ�á�������ʾ������װ�õȡ�
�����������뵼���豸��˾�Ƴ���Model410�͵�ߵоƬ���ϻ���ר�����ڿ�����С�����������豸,��Ҫ����ָ������:
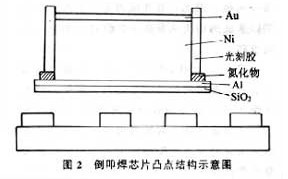
����оƬ�ߴ�:0.25mm��0.25mm��25.4mm��25.4mm;
����ϵͳ����:����̨�����¶���100��ʱ,������Ϊ��5��m;
|

